
Уже зарегистрированы?
Введите данные для входа
Регистрация
Если у вас уже есть аккаунт, войдите через форму входа.
Аккаунт успешно создан
Поздравляем! Ваш аккаунт успешно создан.
Теперь вы можете быстрее оформлять заявки, сохранять данные и отслеживать историю обращений.
Если у вас есть вопросы по работе сайта, пожалуйста, свяжитесь с нами.
Выход из аккаунта
Вы вышли из личного кабинета.
Корзина сохранена, и товары снова появятся после следующего входа.
Благодаря новому пользовательскому интерфейсу, адаптированному для работы в японских условиях, реализован принцип «Простое и мгновенное управление для всех». Кроме того, JPS-9030, оснащённый в стандартной комплектации источником травления Кауфмана и двойным анодом, обладает широкими возможностями расширения, такими как высокотемпературная система нагрева и источник газовых кластерных ионов.
Функции
Широкий анализ, который можно выполнить за короткое время
JPS-9030 — это XPS-спектрометр, способный анализировать образцы большой площади, например, порядка миллиметра, и оптимально подходящий для анализа средних значений. Он позволяет получать информацию об образце независимо от сегрегации и локального загрязнения. Он подходит для элементного анализа и анализа состояния химических связей в образцах из порошков, тонких пленок и пластин.
Пример использования широкополосного анализа – Элементный анализ материала катода LIB
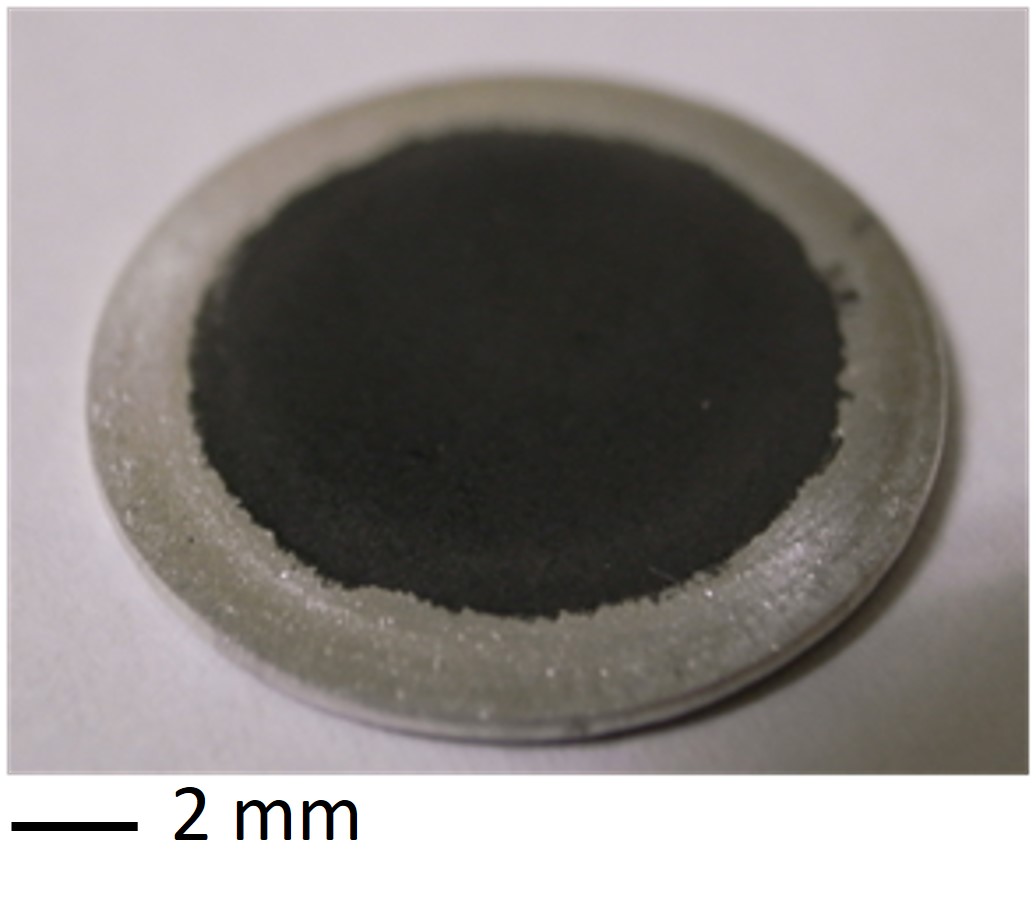
На первый взгляд, материалы катодов ЛИА кажутся однородными. Однако при узком диапазоне анализа результаты элементного анализа могут варьироваться. Расширение диапазона анализа позволяет получить усредненную информацию без влияния локальных загрязнений.
Измерения проводились в трех местах, чтобы сузить диапазон анализа.
⇒Результаты сильно различались.

Измерения проводились в трех местах, чтобы сузить диапазон анализа.
⇒Результаты немного различались.
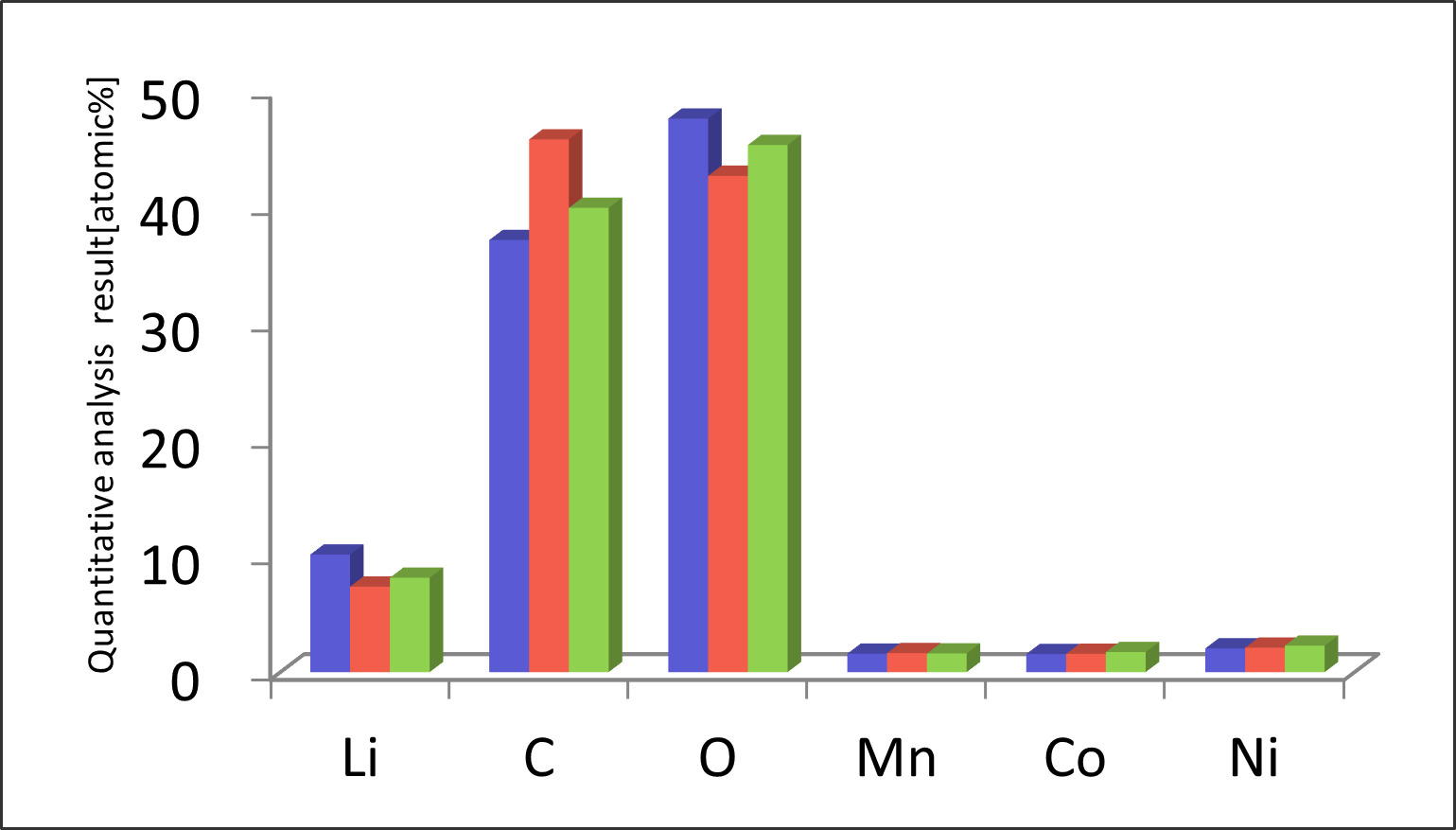
②Программное обеспечение SPECSURF, обеспечивающее простоту эксплуатации
Недавно разработанное программное обеспечение SPECSURF версии 2.0 для японского языка обеспечивает
удобную рабочую среду с использованием только мыши, объединяя графический интерфейс в стиле ленты и систему окон с вкладками.

③Конфигурация прибора, позволяющая проводить измерения широкого спектра материалов – рентгеновский источник с двойным анодом Mg/Al-

В JPS-9030 можно использовать монохроматический рентгеновский источник и рентгеновский источник с двойным анодом Mg/Al. Двойной Mg/Al-анодный рентгеновский источник может переключать рентгеновское излучение для облучения образца между Mg K-излучением и Al K-излучением, что позволяет анализировать образцы, содержащие много элементов, с перекрытием пиков фотоэлектронов и Оже-пика.
-Один щелчок для настройки сохранения, считывания и настройки условий.
-Один щелчок для настройки измерения нескольких образцов.
-Точная функция прогнозирования времени завершения измерения обеспечивает бесперебойную
замену образцов и измерение.
〇Пример использования источника рентгеновского излучения с двойным Mg/Al-анодом – анализ образца, содержащего Fe, Ni
На спектре РФЭС одним из примеров перекрытия пика фотоэлектронов и пика Оже является образец, содержащий несколько переходных металлов. Ниже представлен пример измерения образца, содержащего Fe и Ni. Он показывает, что перекрытия пиков, наблюдаемого при использовании источника рентгеновского излучения на основе алюминия, можно избежать при использовании источника рентгеновского излучения на основе магния.
Измерение с помощью источника рентгеновского излучения Al ⇒ Перекрытие пиков
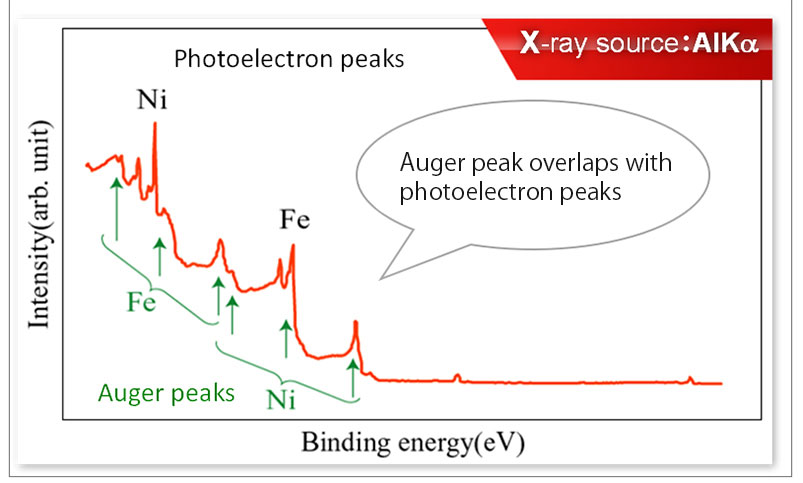
Измерение с помощью источника рентгеновского излучения Mg
⇒ Позволяет избежать перекрытия пиков
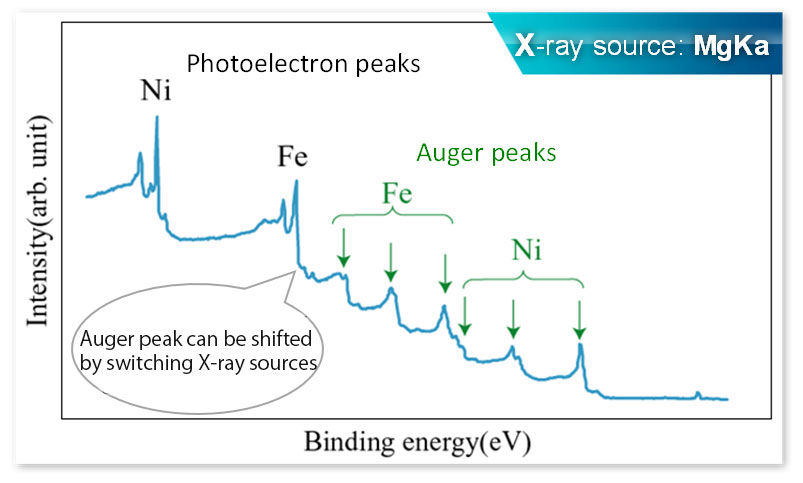
③Конфигурация прибора, позволяющая проводить измерения широкого спектра материалов – источник ионов типа Кауфмана-
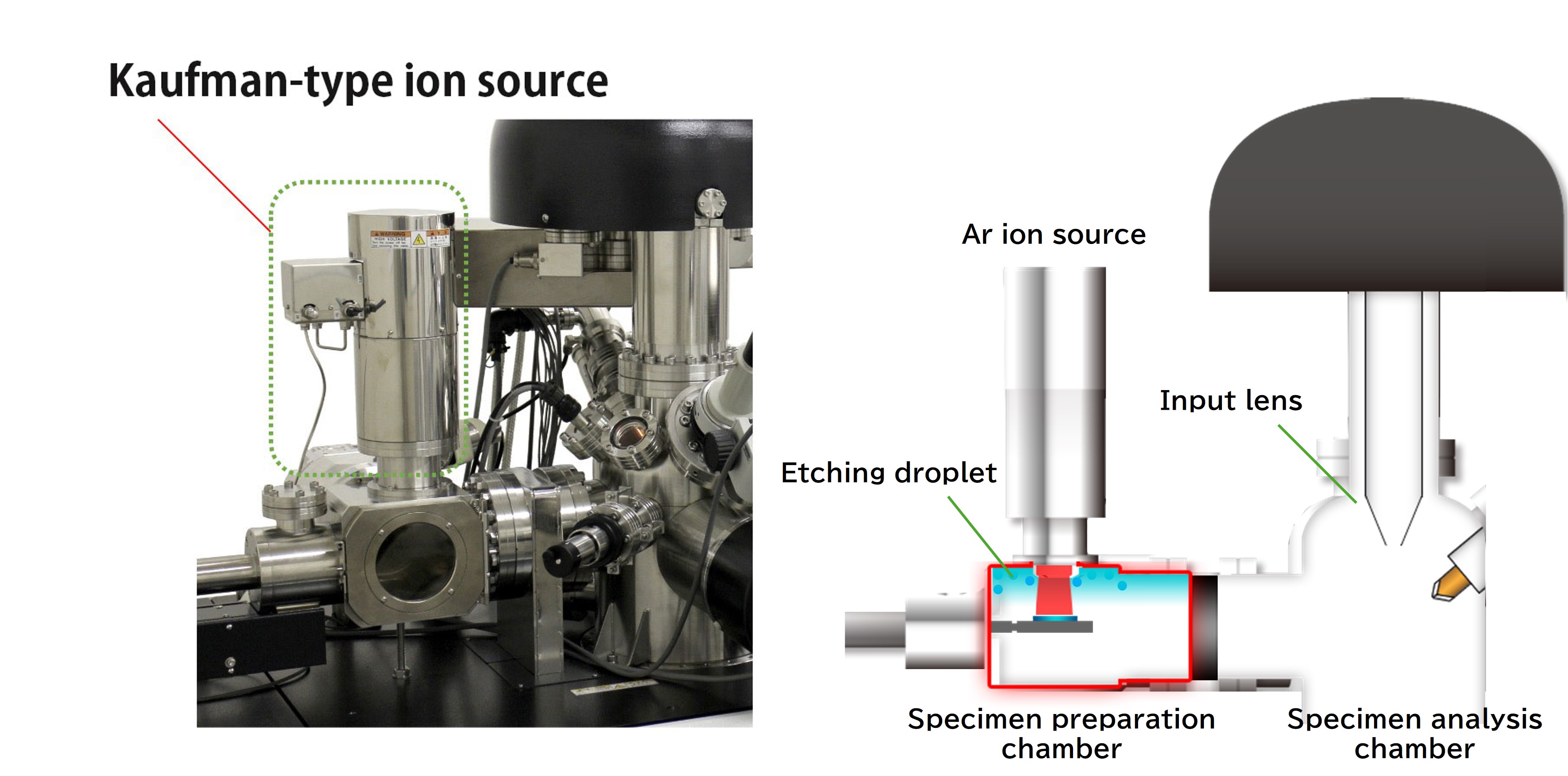
В JPS-9030 в качестве источника ионов аргона используется ионный источник типа Кауфмана. Благодаря высокой силе тока травление можно проводить даже при низком ускоряющем напряжении. Это позволяет сохранять структуру образца.
Источник ионов JPS-9030 размещен в камере подготовки образцов, что ограничивает загрязнение, вызванное травлением внутри камеры подготовки образцов, тем самым предотвращая загрязнение аналитической камеры, которая поддерживает сверхвысокий вакуум.
Пример использования источника ионов типа Кауфмана с многослойным пленочным зеркалом Mo/Si для EUV-литографии
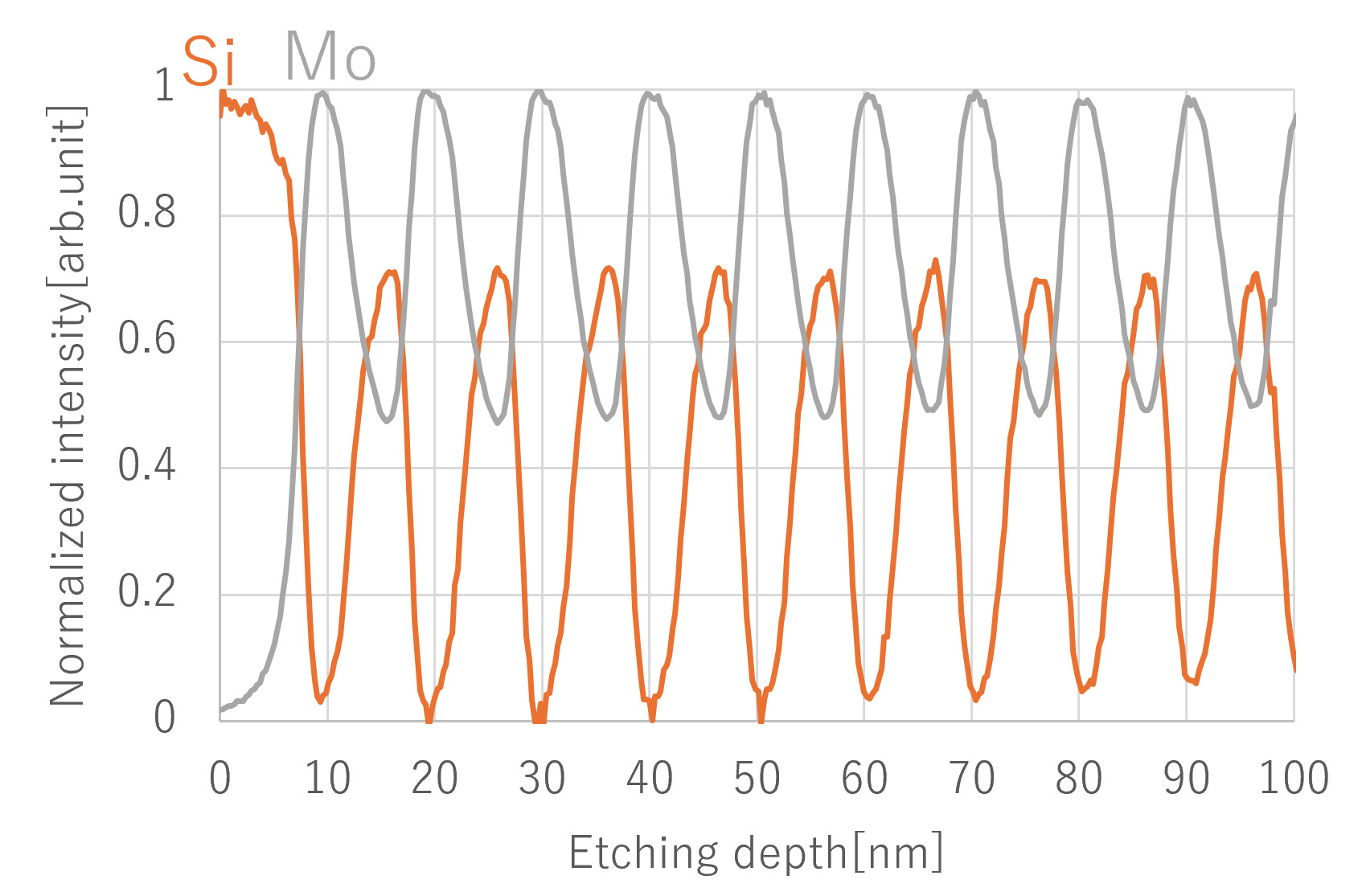
JPS-9030 может облучать образец ионами Ar с низким ускорением, направленными вертикально. Его можно использовать для анализа профиля глубины ультратонких многослойных плёнок. Ниже представлены результаты анализа профиля глубины многослойного плёночного зеркала Mo/Si для литографии в экстремальном ультрафиолетовом диапазоне (EUV).
Можно оценить тонкую плёнку толщиной около 10 нм, сканируя структуру слоёв и оценивая чёткость границы раздела.
③Конфигурация прибора, позволяющая проводить измерения широкого спектра материалов – Другие различные насадки-
JPS-9030 предлагает широкий выбор опций. Более того, мы готовы изготовить навесное оборудование по запросу наших пользователей.
Множество вариантов
- Монохроматический источник рентгеновского излучения, способный улучшить энергетическое разрешение
- Источник кластерных ионов на основе аргона, подходящий для легко повреждаемых органических образцов
- Инфракрасная система отопления повышает температуру до 1000°C
- Сосуд для переноса, обеспечивающий изолированную от воздуха транспортировку образца
Как и указано выше, доступно множество опций, способных удовлетворить любые потребности клиентов.
Что можно сделать с помощью XPS
Примеры анализа (применения) с использованием XPS приведены ниже.
Элементный анализ верхней поверхности
РФЭС позволяет проводить элементный анализ верхней поверхности образца (10 нм и менее).
Это позволяет легко проанализировать органические загрязнители, которые трудно определить по внешнему виду.

ПЭТ (слева) и ПЭТ, загрязненный кремнием на поверхности (справа)
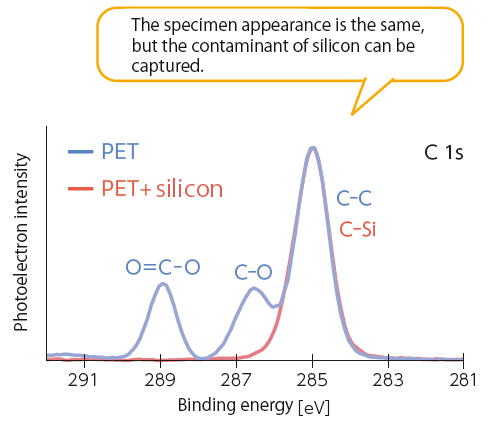
Спектры C 1s ПЭТ, ПЭТ с кремнием
Анализ состояния химических связей
Помимо элементного анализа, РФЭС позволяет проводить анализ состояния химических связей.
Например, в случае литий-ионного аккумулятора можно оценить тип соединения лития, находящегося на электроде.
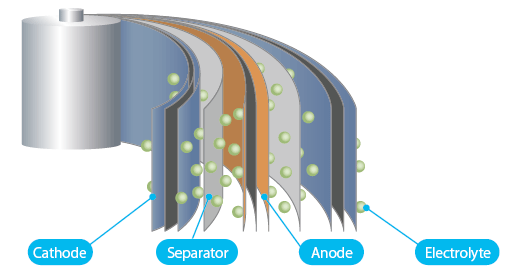
Структура литий-ионного аккумулятора
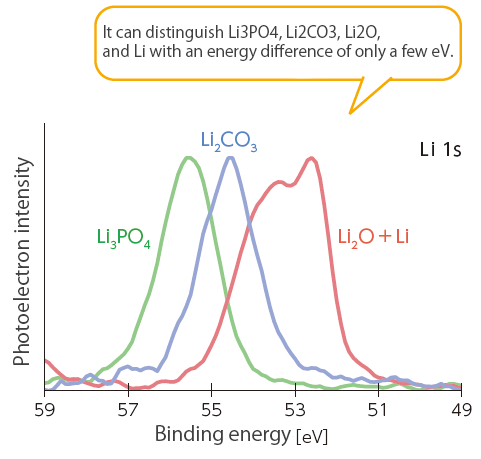
Li 1s спектры различных соединений Li
Анализ профиля глубины
Выполняя анализ профиля глубины с использованием XPS, можно оценить структуру слоев очень тонких образцов толщиной около 10 нм и образцов толщиной в несколько мкм , а также состояние химических связей на границах раздела.
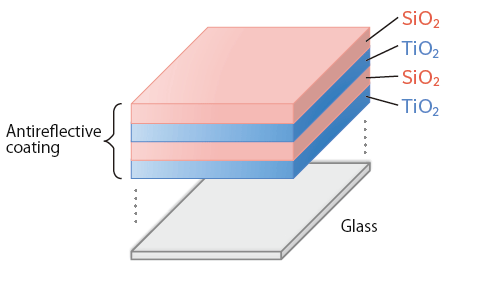
Принципиальная схема антибликового покрытия на поверхности стекла

Результат анализа глубины профиля антибликового покрытия


